3D実装チップでの各層モールド品質管理ポイント
- PoP実装では、モールド部にビアを作る際に設計通りの厚み、かつ均一性が求められる。
- 実装前に各層のモールド状態を把握し、実装時の歩留り向上が求められる。
 MTA解析(モールド厚解析)
MTA解析(モールド厚解析) テラヘルツ波技術による半導体モールド厚の非破壊測定。
簡単な操作で高速自動測定、量産品検査にも最適。
膜厚測定確度±3µm、高密度多層チップのモールドも高精度に測定。
薄型のスマートフォンやタブレット端末などの世界的普及を背景に、半導体デバイスは小型化、高集積化が進んでいます。先端半導体プロセスには、高精度なモールド厚の管理が求められています。
従来のモールディング工程における一般的な品質管理では、モールド厚を非破壊測定する方法が無く、トリム&フォーム工程で切り出した半導体チップをサンプル抽出、裁断し、顕微鏡で観察していました。
「TS9000 MTAオプション」は、半導体にテラヘルツ波を照射し、非破壊かつ高速・高精度にモールド厚を測定する装置です。高速測定により多量サンプル試験やロット単位での厚み分布の把握が容易となり、量産品検査を可能にします。
TS9000MTA は、ストリップ上でモールド不良を検知し、実装時の不具合を無くします。
3D実装チップでの各層モールド品質管理ポイント
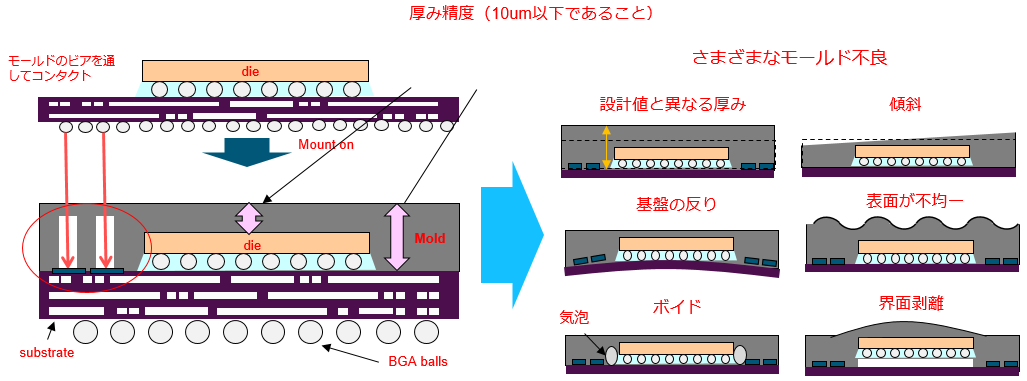
「TS9000 MTAオプション」は、XYステージを備えた測定ユニットに試験デバイスを装着し、複数の測定ポイントを高速測定してモールドの膜厚分布を解析します。測定 ユニットはウエハからストリップ、チップまで、さまざまな形状の半導体デバイスに対応可能です。(JEDECスタンダードチップトレイ対応フィクスチャを 用意しています)
「TS9000 MTAオプション」は、テラヘルツ波を半導体デバイスに照射し、モールド膜の各レイヤで反射されたテラヘルツ波を検出、その時間差から膜厚を解析します。